2016年3月7日
無機半導体のキャリア測定装置
理研No. 07398, 07689
発明者
濱野 哲英(古河機械金属株式会社)、大野 誠吾、南出 泰亜、伊藤 弘昌(理研:テラヘルツ光源研究チーム)
概要
テラヘルツ光を使って、無機化合物半導体のキャリア濃度、キャリア移動度および電気抵抗率を非破壊で短時間に計測できる装置です。※測定対象:GaAs系半導体、GaN系半導体、SiC系半導体、その他
[キャリア濃度の測定]キャリア濃度Nに依存せず反射率Rが一定である参照帯域と、キャリア濃度Nに依存して反射率Rが変化する測定帯域の2つの波長のテラヘルツ光を測定対象の半導体に照射し、測定反射率と参照反射率の対比によって、キャリア濃度Nを算出します。
[キャリア移動度および電気抵抗率の測定]キャリアの減衰定数γや密度Nに依存せず反射率Rが一定である参照帯域と、キャリアの減衰定数γと密度Nに依存して反射率Rが変化する測定帯域の2つのテラヘルツ光を測定対象の半導体に照射し、測定反射率と参照反射率の対比によって、キャリア移動度μ及び電気抵抗率ρを算出します。
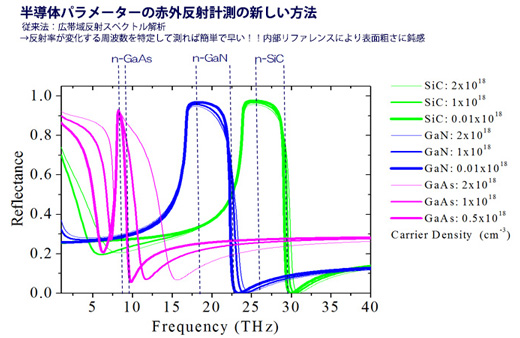
図1:キャリア濃度の測定原理(各種半導体のテラヘルツ光反射率)
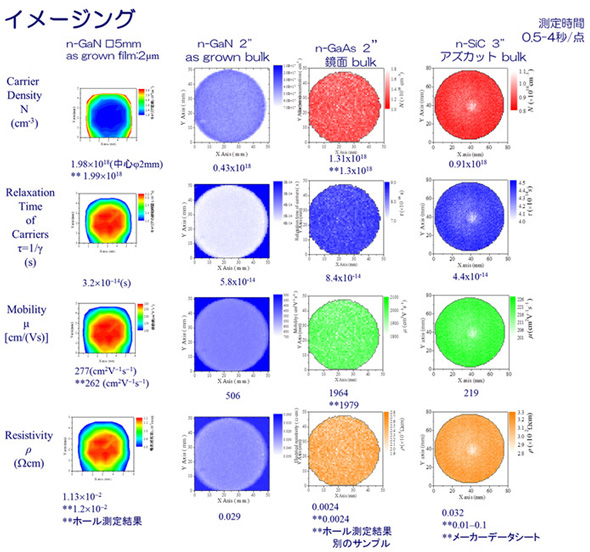
図2:キャリア濃度/キャリア移動度/電気抵抗率の測定結果
利点
- 非破壊・非接触の半導体特性計測
- リファレンスフリーでas-grown基板の計測可能
- 高精度・高空間分解能の高精細マッピング
応用
- 半導体基板の検査・計測
- 半導体成長後から出荷品まで製造工程における非破壊非接触検査
- 半導体面内分布非破壊非接触計測
文献情報
- 1.特許第5063325号、US第8446576号
- 2.特許第5601562号、US第8619243号
- 3.S. Ohno, A. Hamano, K. Miyamoto, C. Suzuki, and H. Ito: J. Eur. Opt. Soc. Rapid Publ. 4 (2009) 09012.
- 4.A. Hamano, S. Ohno, H. Minamide, H. Ito, and Y. Usuki: Jpn. J. Appl. Phys. 49 (2010) 022402.
- 5.A. Hamano, S. Ohno, H. Minamide, H. Ito, and Y. Usuki: Mater. Sci. Forum 778-780 (2014) 491.
知的財産情報に関するお問い合わせ
理化学研究所
お問い合わせフォーム
